
マルチサイトテストにおける問題とは?-その1- |
|
デバイスの信頼性は近年とても重要視されています。色々なデバイスがものすごい勢いで開発され、幅広い分野で大変重要な役割を持つようになりました。その中でも医療、自動車、鉄道etc・・・人命に係わる分野にも多く使用され、デバイスの性能の向上は当然のことながら、それらのデバイスが破壊しないための信頼性にも着目しなければいけません。 |
|
2008年5月 |
| まず、半導体における信頼性試験とは
大まかに分けると、下記3項目です。 設計、製造したデバイスが、、、 ●性能を十分に発揮しているか? ●目標とする品質に達しているか? ●品質を維持しているか? LSIの高集積化が進むにつれて、LSI内部の素子の評価を行うことは非常に艱難になりつつあります。 そこで、信頼性試験の代表的な手法としてTEGを利用した評価試験があります。 信頼性試験をウエハーレベルで行うことで、パッケージ化する必要が無い為、大幅な評価時間短縮が見込めます。また、ウエハー面内のバラつきを評価する事も可能となります。 こうした要望から生まれてきたのが、信頼性試験を「ウエハーレベル」で「多サイト同時」に行うことのできる、弊社製品「MSR(Multi-Site-Reliability)」です。 |
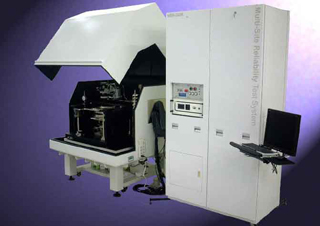 |
.jpg) |
|
|
 |
| 上記以外でもマルチサイトテストにおける問題は複数あります。 ●測定スピードは? ●NBTIでのデバイスリラクゼーションの問題は? ●その他、、、 次回はこの問題について考察してみたいと思います。 |
|
■おまけ用語集のコーナー TDDB・・・経時的絶縁膜破壊(Time Dependent Dielectric Breakdownの略) 酸化膜に電圧を継続的に印加すると、時間とともに酸化膜の破壊の割合が増加する現象のこと。 NBTI・・・(Negative Bias Temperature Instabilityの略) pMOSトランジスタをオン状態にした際に,絶縁膜自身及び絶縁膜とシリコン基板の界面が劣化しトランジスタのしきい値電圧が負側にずれてしまう現象のこと。 |
|
お問い合わせ・資料請求フォーム |
|
|
